新型盲孔填孔技术HDI PCB工艺流程研究(下)
4.2HDI PCB外层整板填孔电镀流程研究,HDI PCB外层整板填孔电镀流程研究
树脂塞孔由于其作用的不同将会对外层流程产生影响。以下就以外层有无树脂塞孔、以及树脂塞孔的作用不同对外层流程进行分类和研究。
4.2.1外层无树脂塞孔流程
对于外层无树脂塞孔,只有盲孔与外层通孔的设计,压合结构如图11。

图11 外层无树脂塞孔
根据外层的制作要求,可以分为正片与负片的流程。
(1)外层制作满足负片要求,且通孔厚径比≤6:1。
负片要求需要满足的条件为:线宽/线隙足够大、最大PTH孔小于干膜最大封孔能力、板厚小于负片要求的最大板厚等。并且没有特殊要求的板,特殊流程的板包括:局部电金板、电镀镍金板、半孔板、印制插头板、无环PTH孔、有PTH槽孔的板等。
内层的制作→压合→棕化→激光钻孔→退棕化→外层钻孔→沉铜→整板填孔电镀→切片分析→外层图形→外层酸性蚀刻→外层AOI→后续正常流程。
(2)外层制作满足负片要求,通孔厚径比>6:1。
由于通孔厚径比>6:1,使用整板填孔电镀无满足通孔孔铜厚度的要求,整板填孔电镀后,需要使用普通的电镀线在进行一次板电将通孔孔铜镀到要求的厚度,具体的流程如下:
内层的制作→压合→棕化→激光钻孔→退棕化→外层钻孔→沉铜→整板填孔电镀→全板电镀→切片分析→外层图形→外层酸性蚀刻→后续正常流程
(3)外层不满足负片要求,线宽/线隙≥a,且外层通孔厚径比≤6:1。
内层的制作→压合→棕化→激光钻孔→退棕化→外层钻孔→沉铜→整板填孔电镀→切片分析→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
(4)外层不满足负片要求,线宽/线隙<a;或线宽/线隙≥a,通孔厚径比>6:1。
内层的制作→压合→棕化→激光钻孔→退棕化→沉铜→整板填孔电镀→切片分析→减铜→外层钻孔→沉铜(2)→全板电镀→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
对于外层只有盲孔和通孔,而没有树脂塞孔设计的HDI板,流程设计主要应该考虑的问题是,通孔的厚径比和线宽/线隙的大小。当线宽/线隙满足负片的预大要求时,优先考虑使用负片制作。
4.2.2外层有树脂塞孔流程
外层既有盲孔和通孔,又有树脂塞孔的HDI板(图12),根据树脂塞孔的孔上方是否需要做焊盘(pad),又可将分为Via-in-pad和No via-in-pad。
Via-in-pad是指:树脂塞孔上方需要做盖覆铜工艺流程,简称VIP。
No Via-in-pad是指:树脂塞孔上方不需要盖覆铜的工艺流程,简称非VIP。

图12 外层有树脂塞孔
(1)对于No via-in-pad要求的HDI PCB,根据能否满足负片的要求,设计流程。
此种类型的HDI PCB,树脂塞孔的孔必须和外层通孔需要一起制作。根据能否满足负片要求选择工艺流程。
①外层满足负片要求,根据线宽/线隙的制作能力选择合适的工艺流程。
(A)当线宽/线隙≥b时,树脂塞孔的孔和外层通孔的厚径比均≤6:1。
内层的制作→压合→棕化→激光钻孔→退棕化→外层钻孔(同时钻出树脂塞孔的孔、外层通孔)→沉铜→整板填孔电镀→切片分析→树脂塞孔(必须使用选择性塞孔制作)→砂带磨板→外层图形→外层酸性蚀刻→外层AOI→后续正常流程。
(B)当c<且线宽/线隙<b时,可不考虑通孔厚径比,只选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→沉铜→整板填孔电镀→切片分析→减铜→外层钻孔(同时钻出树脂塞孔的孔、外层通孔)→沉铜→全板电镀→树脂塞孔(必须使用选择性塞孔制作)→砂带磨板→外层图形→外层酸性蚀刻→外层AOI→后续正常流程。
(C)当线宽/线隙<c时,也可不考虑通孔厚径比,选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→沉铜→整板填孔电镀→切片分析→减铜→外层钻孔(同时钻出树脂塞孔的孔、外层通孔)→沉铜→全板电镀→外层镀孔图形→镀孔→褪膜→树脂塞孔(必须使用选择性塞孔制作)→砂带磨板→外层图形→外层酸性蚀刻→外层AOI→后续正常流程。
②外层不满足负片要求,需根据线宽/线隙的制作能力选择合适的工艺流程。
(A)当线宽/线隙≥b时,树脂塞孔的孔和外层通孔的厚径比均≤6:1。
内层的制作→压合→棕化→激光钻孔→退棕化→外层钻孔(同时钻出树脂塞孔的孔、外层通孔)→沉铜→整板填孔电镀→切片分析→树脂塞孔(必须使用选择性塞孔制作)→砂带磨板→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
(B)当c<且线宽/线隙<b时,可不考虑通孔厚径比,只选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→沉铜→整板填孔电镀→切片分析→减铜→外层钻孔(同时钻出树脂塞孔的孔、外层通孔)→沉铜→全板电镀→树脂塞孔(必须使用选择性塞孔制作)→砂带磨板→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
(C)当线宽/线隙<c时,也可不考虑通孔厚径比,选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→沉铜→整板填孔电镀→切片分析→减铜→外层钻孔(同时钻出树脂塞孔的孔、外层通孔)→沉铜→全板电镀→外层镀孔图形→镀孔→褪膜→树脂塞孔(必须使用选择性塞孔制作)→砂带磨板→外层图形→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
(2)对于via-in-pad要求的HDI板外层流程需要考虑的几个方面,以及工艺流程设计如下:
由于此种类型的HDI板,树脂塞孔的孔必须和外层通孔分开制作。因此,需要考虑树脂塞孔的孔能否与盲孔一起制作。根据能否满足负片要求选择工艺流程。
外层满足负片要求,根据线宽/线隙的制作能力选择合适的工艺流程。
①当线宽/线隙≥b时,树脂塞孔的孔和外层通孔的厚径比均≤6:1。
内层的制作→压合→棕化→激光钻孔→退棕化→钻树脂塞孔的孔→沉铜→整板填孔电镀→切片分析→树脂塞孔→砂带磨板→外层钻孔→沉铜→全板电镀→外层图形→外层酸性蚀刻→外层AOI→后续正常流程。
②当c<且线宽/线隙<b时,可不考虑通孔厚径比,只选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→钻树脂塞孔的孔→沉铜→整板填孔电镀→切片分析→树脂塞孔→砂带磨板→减铜→不织布抛光→外层钻孔→沉铜→全板电镀→外层图形→外层酸性蚀刻→外层AOI→后续正常流程。
③当线宽/线隙<c时,也可不考虑通孔厚径比,选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→沉铜→整板填孔电镀→切片分析→减铜→钻树脂塞孔的孔→沉铜→全板电镀→镀孔图形→镀孔→切片分析→褪膜→树脂塞孔→砂带磨板→外层钻孔→沉铜→全板电镀→外层图形→外层酸性蚀刻→外层AOI→后续正常流程。
(3)外层不满足负片要求,根据线宽/线隙的制作能力选择合适的工艺流程。
①当线宽/线隙≥b时,树脂塞孔的孔和外层通孔的厚径比均≤6:1。
内层的制作→压合→棕化→激光钻孔→退棕化→钻树脂塞孔的孔→沉铜→整板填孔电镀→切片分析→树脂塞孔→砂带磨板→外层钻孔→沉铜→全板电镀→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
②当c<且线宽/线隙<b时,可不考虑通孔厚径比,只选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→钻树脂塞孔的孔→沉铜→整板填孔电镀→切片分析→树脂塞孔→砂带磨板→减铜→不织布抛光→外层钻孔→沉铜→全板电镀→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
③当线宽/线隙<c时,也可不考虑通孔厚径比,选择以下工艺流程。
内层的制作→压合→棕化→激光钻孔→退棕化→沉铜→整板填孔电镀→切片分析→减铜→钻树脂塞孔的孔→沉铜→全板电镀→镀孔图形→镀孔→切片分析→褪膜→树脂塞孔→砂带磨板→外层钻孔→沉铜→全板电镀→外层图形→图形电镀→外层碱性蚀刻→外层AOI→后续正常流程。
5.总结
本文根据新的盲孔填孔电镀技术的应用,分析HDI PCB内层、外层的不同设计要求,设计出不同的工艺流程,从而能够达到减少HDI板的生产流程、缩短HDI PCB的生产周期、降低HDI板的生产成本,提升HDI PCB的生产品质。
ps:部分图片来源于网络,如有侵权,请联系我们删除
最新产品
通讯手机HDI
-

-
型号:GHS08K03479A0
阶数:8层二阶
板材:EM825
板厚:0.8mm
尺寸:144.08mm*101mm
最小线宽:0.075mm
最小线距:0.075mm
最小孔径:0.1mm
表面处理:沉金+OSP
通讯手机HDI
-

-
型号:GHS06C03294A0
阶数:6层二阶
板材:EM825
板厚:1.0mm
尺寸:92mm*118mm
最小线宽:0.075mm
最小线距:0.075mm
最小孔径:0.1mm
表面处理:沉金
通讯模块HDI
-

-
型号:GHS04K03404A0
阶数:4层一阶+半孔
板材:EM825
板厚:0.6mm
尺寸:94.00*59.59mm
最小线宽:0.076mm
最小线距:0.076mm
最小孔径:0.1mm
表面处理:沉金+OSP
5G模块PCB
P1.5显示屏HDI
-

-
型号:GHS04C03605A0
层数:4层一阶
所用板材:EM825
板厚:1.6mm
尺寸:24mm*116mm
最小盲孔:0.1mm
最小埋孔:0.2mm
最小线宽:0.13mm
最小线距:0.097mm
表面处理:沉金
外形公差:+0.05/-0.15mm(板内无定位孔)
特殊要求:灯窝间距:P1.5
P2.571显示屏HDI
-

-
型号:GHS04C03429A0
阶层:4层一阶
板材:EM825
板厚:1.6mm
尺寸:215.85mm*287.85mm
最小盲孔:0.1mm
最小埋孔:0.2mm
最小线宽:0.152mm
最小线距:0.152mm
表面处理:沉金
外形公差:+/-0.15mm(板内无定位孔)
特殊要求:控深钻帽子电镀间距:P2.571
P1.9显示屏HDI
-

-
型号:GHM08C03113A0
阶层:8层一阶
板材:EM825
板厚:1.6mm
尺寸:239.9mm*239.9mm
最小盲孔:0.1mm
最小埋孔:0.2mm
最小线宽:0.127mm
最小线距:0.127mm
表面处理:沉金
外形公差:+0.05/-0.15mm(板内无定位孔)
特殊要求:控深钻间距:P1.9
P1.923显示屏HDI
同类文章排行
- 2017年度中国电子电路板PCB百强企业排行榜
- 2017全球PCB制造企业百强排行榜
- 2014年线路板厂综合排名——你必须知道!
- 世界顶级电路板厂商排行榜
- HDI厂之2015全球百大PCB企业榜单出炉,中国大陆PCB企业占34家!
- HDI PCB的应用及其优势
- 看4G与5G基站电路板需求对比
- 实拍赣州深联线路板厂生产车间,PCB全流程惊艳你的视野
- 2018年电路板行业原材料涨价潮又要开始了
- 电路板厂教你快速识别PCB绿色产品标识
最新资讯文章
- HDI 板行业趋势洞察:未来之路在何方?
- 一个卓越的电路板厂需要具备哪些关键条件?
- PCB 厂凭啥能成为电子产业的 “幕后英雄” ?
- 未来 PCB 将迎来哪些颠覆性突破?
- 绿色环保趋势下,汽车软硬结合板材料如何革新?
- PCB 行业未来十年,将迎来哪些颠覆性变革?
- 智能化浪潮下,汽车软硬结合板如何赋能智能驾驶?
- 未来电路板会在物联网应用中有何新突破?
- 软硬结合板凭什么在汽车电子中备受青睐?
- 手机无线充线路板的未来发展方向在哪?









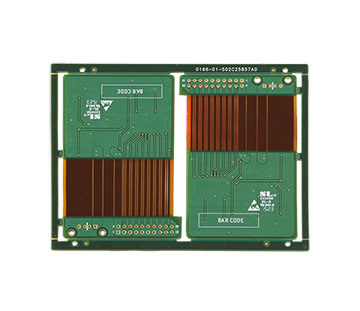





共-条评论【我要评论】