HDI板栓孔凸块会依据使用目的不同而有不同的形式。图5.13是栓孔下孔利用电镀铜填起来的填充栓孔。和均匀镀层栓孔比较起来,填充栓孔需要较长的制程时间且成本较高。图5.14是栓孔和栓孔之间互相重叠的栓孔凸块,如图5.15栓孔凸块可以直接与晶片的覆晶片接合部分接触,因此可以达到HDI板的更高线路密度。填充栓孔是将均匀镀层栓孔利用电镀铜或填入其他导电材料,图5.16则是铜凸块的照片。


铜凸块的剥离法形成制程如图5.17.
1.一开始必须先在HDI板基板表面利用无电镀铜方式形成一层导电层。
2.然后涂布光阻进行曝光显影的步骤,定义出电镀铜形成凸块的位置。
3.利用1.的无电镀铜层作为层电层进行电镀形成铜凸块。
4.去除光阻,然后蚀刻去除作为导电层的无电镀铜。
5.涂布绝缘层。
6.将表面平坦会使凸块的头部露出栓孔。
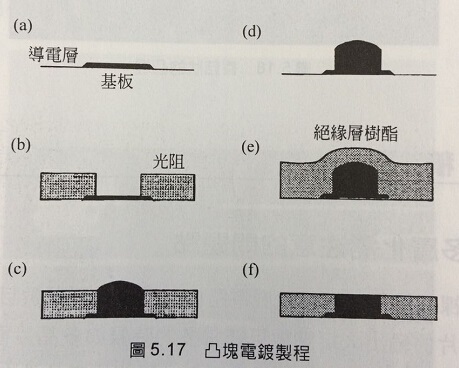
在进行上述凸块的HDI板电镀制程时,必须特别注意栓孔密度分布不均匀的区域、基板的四周和中央部分,由于电流密度不同,因此会形成高度不同的凸块。如果形成的凸块太高时会变成图5.18的香菇状。


 通讯手机HDI
通讯手机HDI 通讯手机HDI
通讯手机HDI 通讯模块HDI
通讯模块HDI